ATOS|Tech News
使用數字影像相關法(DIC)為半導體產業提供全面性檢驗
(Digital Image Correlation,DIC)
ARAMIS 3D 動態與應變量測系統,應用了DIC(Digital Image Correlation)量測技術,左右兩眼相機同時拍攝物件表面,透過對極幾何原理精準地得到工件表面座標位置,並建立工件表面3D網格資料,再將變形破壞過程拍攝記錄,最終可在一次的量測裡面得到所有的動態數據,包含位移、速度、加速度、應變、剪應變、夾角變化等。能夠有效的在半導體產業中,提供全面性檢驗。
半導體產業中,大多會對晶圓或是封裝後晶片進行熱變形的實驗及驗證,針對其變形量及應變的功能分析,以確保成品品質。


晶片全域翹曲(Warpage)應用
想要對晶片做全域翹曲檢驗,可以透過溫控設備對樣品進行升降溫,將其溫度設定在零下65度到260度,並將在各個溫度點的晶片狀態,利用ARAMIS 3D 動態與應變量測系統拍攝下來,並進行 Warpage、CTE等參數分析。

與實物影像結合分析各溫度點Warpage,並以色彩圖視覺化顯示翹曲高低分佈
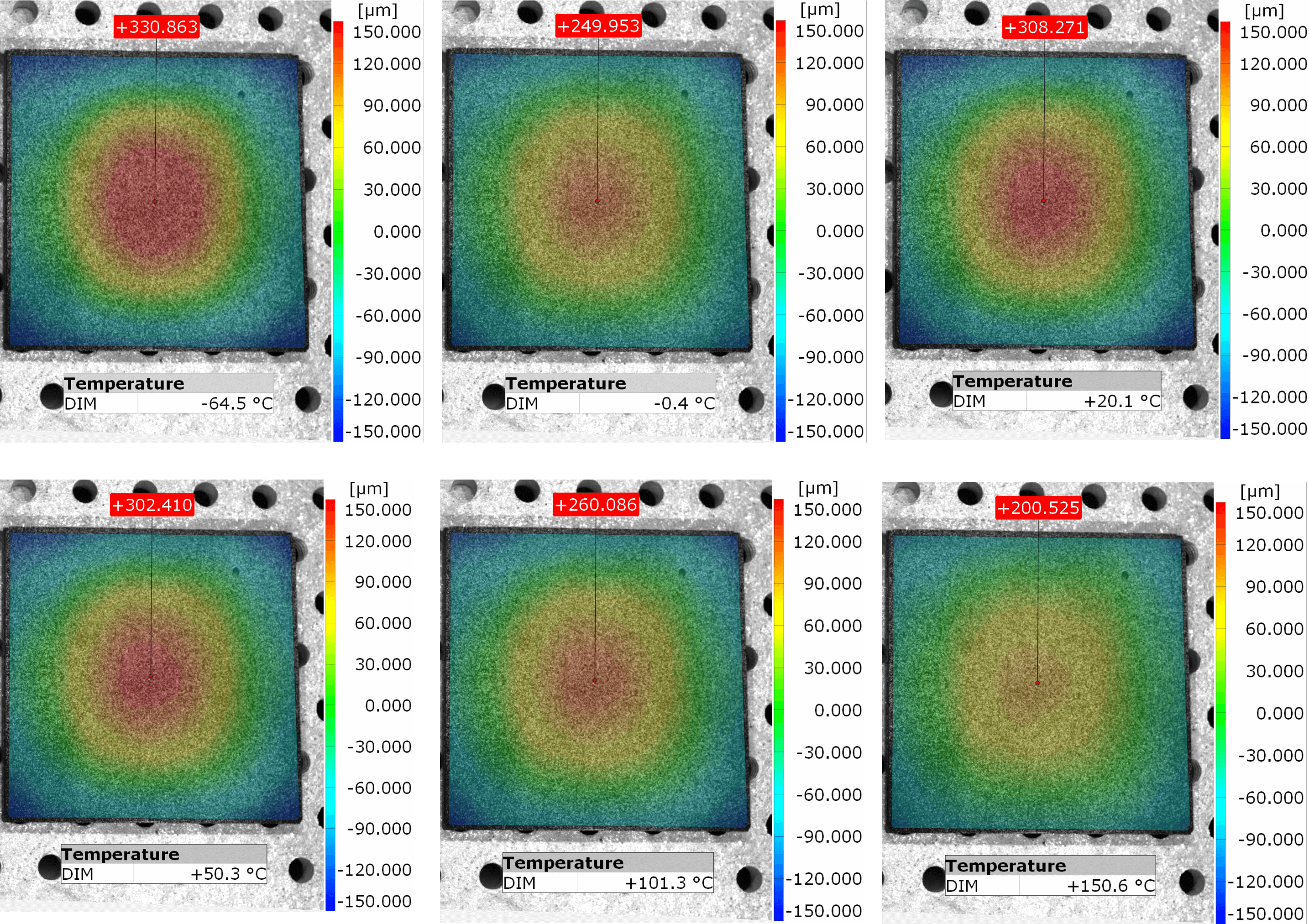
利用軟體將Warpage分析結果以 3D 色彩增強其高度的顯示效果;以及CTE熱膨脹係數分析表,在每個溫度的變形量皆能一目了然

組裝熱變形檢測應用
而在實際產品驗證上,例如電腦工作時產生熱量,使CPU、記憶體等,因晶片與PCB間膨脹程度的不同,容易在In plane方向產生的相對位移,以及Out of plane 方向產生不同程度的翹曲,在這種狀態下時常伴隨發生硬體的失效。透過 GOM ARAMIS 3D 動態與應變量測系統,能夠在一次的量測即分析以上全部的需求,並且可更進一步結合熱影像儀器同時監控溫度與變形翹曲,進行故障分析。
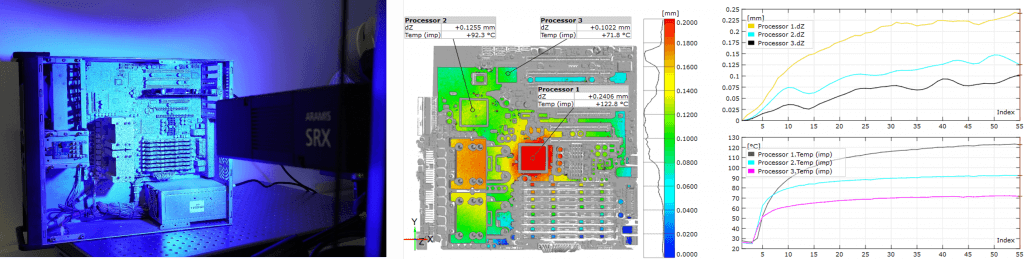
透過影像,可以看到因晶片及PCB板熱膨脹程度不同產生的相對位移,以及晶片自身變形及相對 PCB板的位移差異
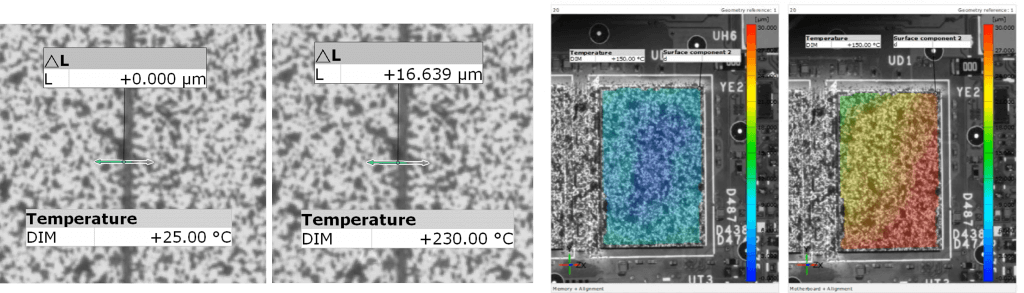
除了翹曲變形, GOM ARAMIS也能用來高速撞擊及落摔量測應用
除了上述的晶片、PCB的熱膨脹翹曲變形測試,最後的成品如筆記型電腦或是手機等3C電子產品,產品組裝完成後還會有大量的測試需求。像是落摔測試可以藉由ARAMIS系統得到更全域的變形狀況,搭配高速攝影機以每秒拍攝數千甚至上萬張的速度拍攝摔落、撞擊的過程,即便是只有不到0.1秒的變形瞬間,都可以被完整的被記錄。
而大多數的實驗室、研究單位大多只能從影像去觀測、想像產品發生了什麼變化,無法資料數據化,以科學的方式去討論及改善。利用ARAMIS量測系統不論是金屬還是塑膠外殼又或是螢幕玻璃,皆能得到整面的3D網格及變形數據,進階應用甚至可結合模擬數據做比對,輔助修正模擬參數使結果更接近真實情況,以便日後縮短開發時程。
綜合上述應用,GOM ARAMIS 3D 動態與應變量測系統除了Out of plane、Warpage分析外,同時兼具了In plane方向的量測與應變分析功能,並且在各種關於高度段差、階高設計的樣品上同樣可以進行量測,打破各種類型專用機台,無法同時滿足In plane及Out of plane上的量測限制,再加上特有的熱膨脹係數CTE的分析, GOM ARAMIS 3D 動態與應變量測系統是集所有能力於一身的最佳實驗利器。
您可能感興趣...
作者資訊






